ETCHER EQUIPMENT
▮ ETCHER equipment core technology ▮
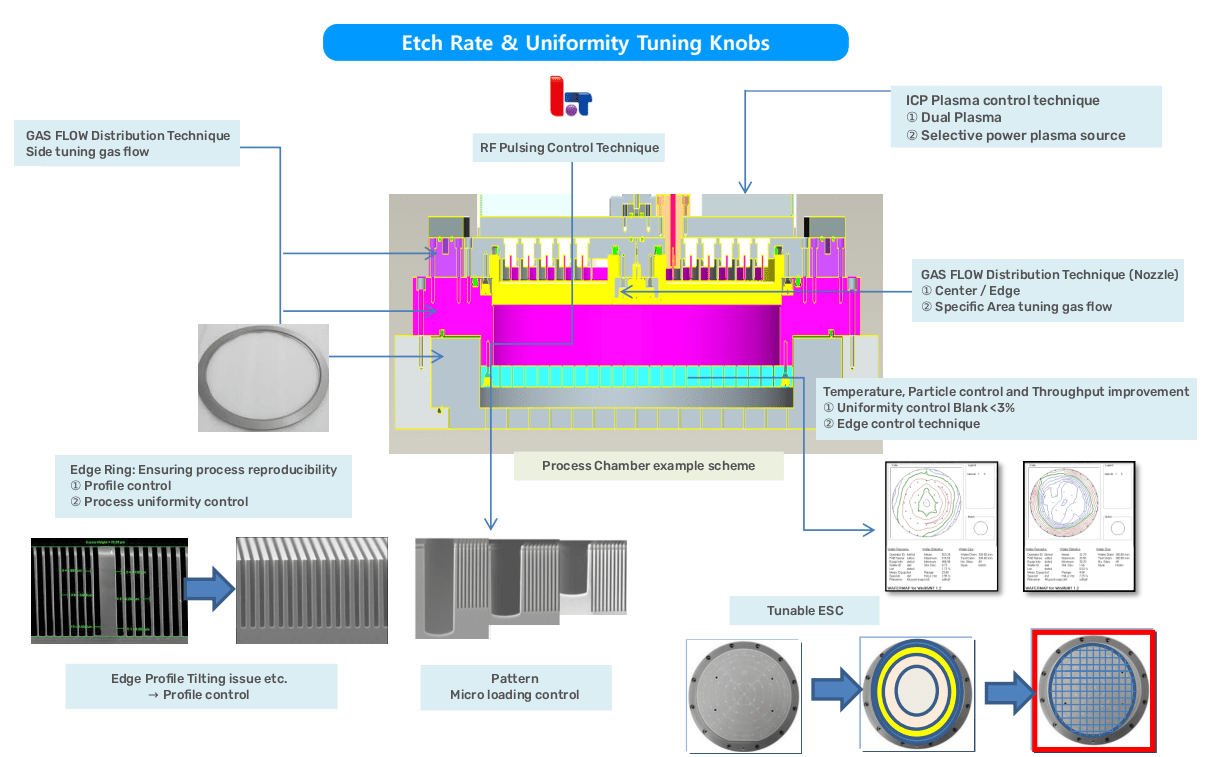
Process spec
| NO | ITEM | CONTENT | EXAMPLE | REMARK |
|---|---|---|---|---|
| 1 | Uniformity |
• <3% based on 49 points of general blank wafer: Base
• Blank Uniformity Management ⇒ Specific Point Concept Management
Example: Edge Area High E/R Management
Area-Specific Management
|

|
Implementation of various shape ETCHMAPs |
| 2 | Profile |
• Edge Profile Tilting Control
⇒ RF Pulsing / Edge Application / Side Gas …
|
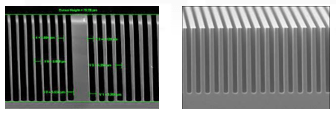
|
Implementation of PROFILE tailored to tilting control and process characteristics |
| 3 | Micro loading |
• Center/Edge Difference Point-by-Point Profile Shape Control
⇒ Apply RF Pulsing
• Minimize Wide/Dense Area Variance
|

|
• RF Frequency • GAS Flow (MFC Control) • Implementation possible according to device/step characteristics |
Hardware factor
| NO | ITEM | CONTROL | REMARK |
|---|---|---|---|
| 1 | GAS Distribution |
• TOP Tuning GAS (Nozzle) & Gas Amount Control
• STG ( Side Tuning gas)
• Process Kits (Gas Nozzle, Focus Ring)
|
• Uniformity • CD • Profile |
| 2 | Temp control |
• ESC( 2-> 4->Multi zone)
• 4zone mostly applied/some multi applied, ESC Temp
|
• Uniformity • CD • Profile |
| 3 | RF |
•
Pulsing ( bias >source-> both) • Frequency & Bias Power Control |
• Uniformity • CD • Selectivity • Micro loading |
▮ ETCHER system core HARDWARE development ▮
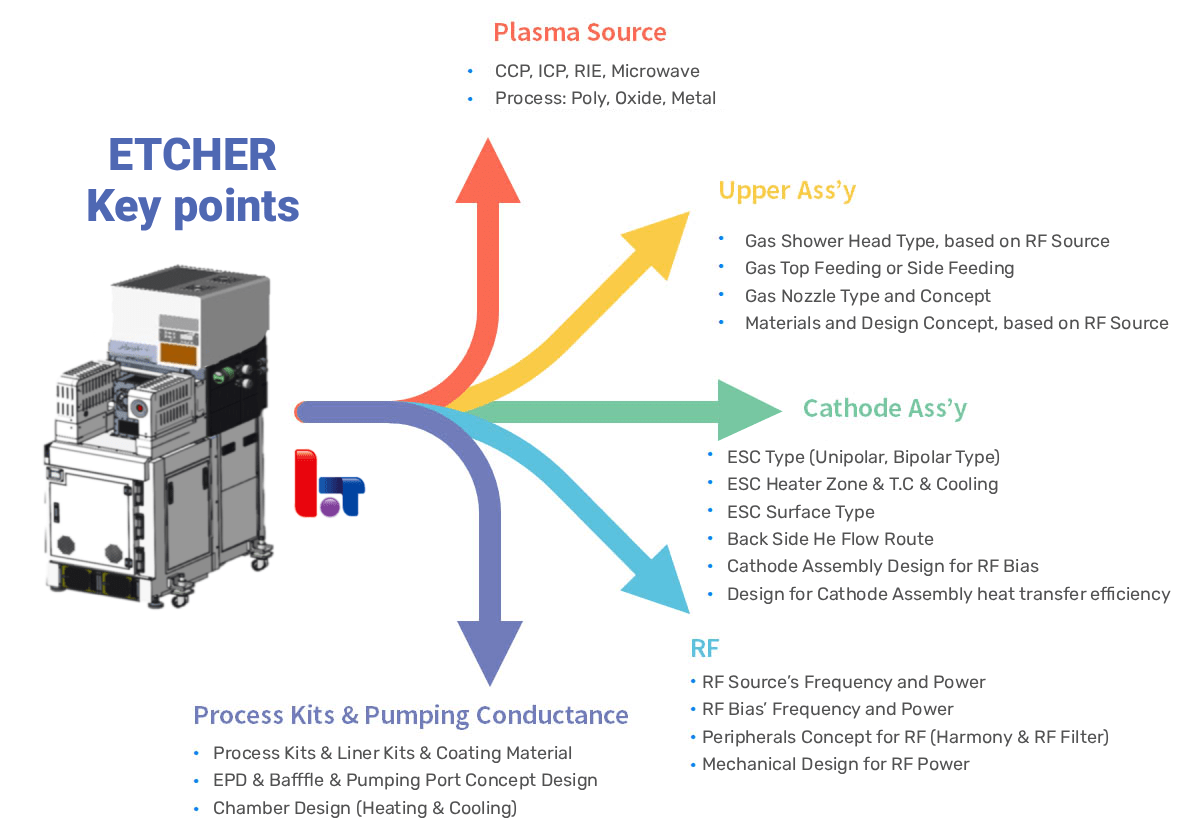
etcher key points
- Plasma Source
- CCP, ICP, RIE, Microwave
- Process: Poly, Oxide, Metal
- Upper Assembly
- Gas Shower Head Type, based on RF Source
- Gas Top Feeding or Side Feeding
- Gas Nozzle Type and Concept
- Materials and Design Concept, based on RF Source
- Cathode Assembly
- ESC Type (Unipolar, Bipolar Type)
- ESC Heater Zone & T.C & Cooling
- ESC Surface Type
- Back Side He Flow Route
- Cathode Assembly Design for RF Bias
- Design for Cathode Assembly heat transfer efficiency
- RF
- RF Source’s Frequency and Power
- RF Bias’ Frequency and Power
- Peripherals Concept for RF (Harmony & RF Filter)
- Mechanical Design for RF Power
- Process Kits & Pumping Conductance
- Process Kits & Liner Kits & Coating Material
- EPD & Baffle & Pumping Port Concept Design
- Chamber Design (Heating & Cooling)
▮ LAON ETCHER Equipment

Dicing Plasma PM
| SOURCE | CCP |
| Wafer size | 12” |
| RF | Top & Bottom |
| Process Chamber | Bottom Side Pumping Concept 2~4 CHAMBER |
| Process Gas | Dual Zone Gas Feed |
| ESC | Bipolar & Dual Backside He Control |

ETCH Plasma PM
| SOURCE | ICP, CCP |
| Wafer size | 12” |
| RF | Top & Bottom |
| Process Chamber | Center Pumping Concept 2~4 CHAMBER |
| Process Gas | Dual Zone Gas Feed |
| ESC | Unipolar & Dual Backside He Control |
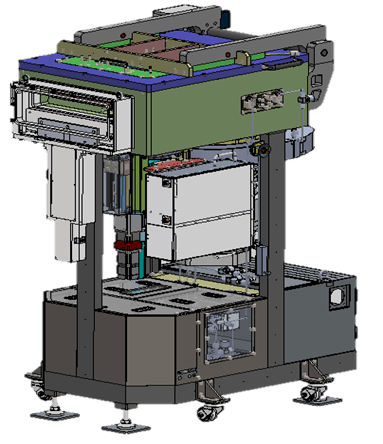
Pe_Cleaning Plasma PM
| SOURCE | RIE |
| Wafer size | Wafer, Glass |
| RF | 13.56MHz |
| Process Chamber | Bottom Pumping Concept |
| Process Gas | Single Top Feed |
| ESC | None |

Electrostatic Discharge Plasma Module
| SOURCE | ICP |
| Wafer size | Wafer, Glass |
| RF | 13.56MHz |
| Process Chamber | Side Pumping Concept |
| Process Gas | Single Side Feed |
| ESC | None |
