LAON VALVES FIELD TEST
Customer Demo Evaluation | O-Ring Corrosion Test | Polymer Depo. Test
▮ BPS-CG/RG Customer evaluation ▮
Dry Pump AGV Protection Gate Valve
Evaluated parameters:
◈ Particle Check (Pump Down) ◈ Polymer DEPO.
◈ Valve Speed (< 0.1 sec) ◈ O-ring Corrosion

| Process | M/C | M/N | Module | V/V Size | V/V Position | Evaluation result | |
|---|---|---|---|---|---|---|---|
| Diffusion | MTO | TEL | INDYPLUS | PM | Φ160mm | Pump Inlet | EXCELLENT (SAMSUNG, SK Hynix) |
| Diffusion | ALD | TEL | INDYPLUS | PM | Φ160mm | Pump Inlet | |
| ETCH | METAL | AMAT | CENTURA | L/L | Φ80mm | Pump Inlet | |
| ETCH | METAL | LAM | KIYO | PM | Φ125mm | Pump Inlet | |
| ETCH | ASHING | PSK | SURPA5M | PM | Φ160mm | Pump Inlet | |
| Diffusion | ALD | TEL | – | PM | Φ160mm | Pump Inlet | |
| ETCH | Poly | LAM | KIYO | PM | Φ125mm | Pump Inlet | |
| PVD | W | AMAT | ILTIMA | PM | Φ100mm | Pump Inlet | |
| PVD | STI | AMAT | ULTIMA | PM | Φ100mm | Pump Inlet | |
| ETCH | Oxide | TEL | DRM | TM | Φ100mm | Pump Inlet | |
| ETCH | ASHING | RAMCO | RAM-8500 | PM | Φ50mm | Pump Inlet | |
| Diffusion | – | FAB | – | PM | Φ160mm | Pump Inlet | |
| PVD | – | FAB | – | PM | Φ160mm | Pump Inlet | |
| PVD | – | FAB | – | PM | Φ100mm | Pump Inlet | |
| PVD | – | FAB | – | PM | Φ80mm | Pump Inlet | |
| PVD | WIN | LAM | ALTUS | PM | Φ100mm | Ch. Iso V/V | |
| – | – | – | – | PM | Φ50mm | Ch. Iso V/V | |
| Static electricity removal system | – | – | PM | Φ50/100mm | Ch. Iso V/V | ||
ITEMS:
◈ Polymer DEPO.
◈ Valve Leak ◈ O-ring Corrosion

| Process | M/C | M/N | Module | V/V Size | V/V Position | Evaluation result | |
|---|---|---|---|---|---|---|---|
| ETCH | OXIDE | LAM | KIYO | Ch. | NW25,NW40 | PM | EXCELLENT (SAMSUNG, SK Hynix) |
| ETCH | METAL | LAM | TCP9600 | Ch. | NW40 | PM | |
| ETCH | METAL | AMAT | CENTURA | Ch. | NW25,NW40 | PM | |
| ETCH | METAL | Equipment manufacturer | – | Ch. | NW40 | PM | |
| ETCH | OXIDE | Equipment manufacturer | – | Ch. | NW25,NW40 | PM | |
| CVD | – | Equipment manufacturer | – | Ch. | ISO 160 | PM | |
You can find specification for our valves here:
▮ O-ring corrosion and contamination field test data ▮
▮ Field Test Data (Particle)
Particle Data at LOAD LOCK

Equipment: SAMSUNG (AMAT / Centura DPS)
Process: Etch (Metal)
| Particle Check Point | Company “A” Valve Particle Data(ea) | LAON BPS Valve Particle Data(ea) | LAON Particle reduction rate(%) |
|---|---|---|---|
| At Pumping Pressure <1 Torr, Pump Down | 8,813 | 3 | 99.9660% |
| 17,675 | 7 | 99.9604% | |
| At Pumping Pressure 10 Torr, Pump Down | 96,235 | 33 | 99.9657% |
| 31,583 | 50 | 99.8417% | |
| At Pumping Pressure 100 Torr, Pump Down | 107,709 | 39 | 99.9638% |
Particle Data at PROCESS CHAMBER

Equipment: SAMSUNG (PSK / SUPRA5M)
Process: Etch (Ashing)
| Particle Check Point | Company “B” Valve Particle Data(ea) | LAON BPS Valve Particle Data(ea) | LAON Particle reduction rate(%) |
|---|---|---|---|
| At Pumping Pressure 1 Torr, Pump Down | 650 | 10 | 99.46% |
| At Pumping Pressure 5 Torr, Pump Down | 1183 | 3 | 99.75% |
| At Pumping Pressure 100 Torr, Pump Down | 22 | 13 | 40.91% |
Particle Data at PROCESS CHAMBER

Equipment: SK Hynix (Lam / Kiyo)
Process: Etch (Poly)
Particle Wafer (Order: loading ⇒ PM(3min) ⇒ unloading) Particle Data compared during Pump ON and OFF states.
| Condition | Particle Data(ea) | Base Pressure | Foreline Pressure |
|---|---|---|---|
| Pump ON | 11 | 12.5mT | 16mT |
| Pump Down | 11 | 12.8mT | 16mT |

BPS Valve Installation Test Results: No change in chamber pressure when Pump is OFF.
Excellent back stream prevention and P/T control capabilities.
▮ Field Test Data (Polymer Depo.)
Chamber Isolation Gate Valve Application

Equipment: SK Hynix- ALTUS (Lam)
Process: CVD(WN)
Test duration: 60,000 wafer cycles ( 3 Months )
| Gate Valve | Company “V” Valve | LAON BPS Valve |
|---|---|---|
| Results | • Drive unit malfunctioned due to polymer deposition • Large amounts of polymer deposition on the O-ring housing plate and bearing | • Polymer Depo. EH (Housing, Sealing Plate) • Close O-ring, no corrosion or contamination |
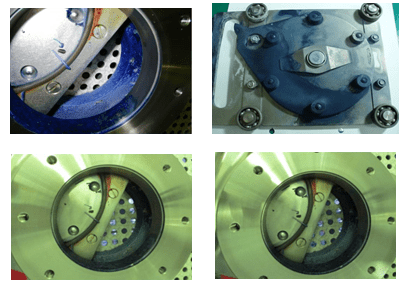
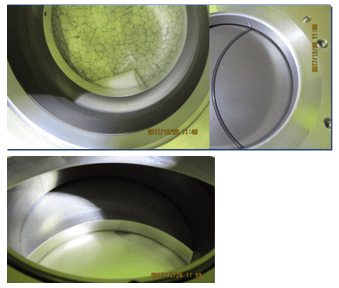
Particle Data at PROCESS CHAMBER

Equipment: SK Hynix (AMAT / ULTIMA)
Process: CVD(STI & W)
Test duration: 3 months
BPS Demo Test due to corrosion problem with Kalrez O-Rings
Mass production equipment evaluation results
• Good condition without contamination
• No visible symptoms of polymer deposition
• Reduced maintenance costs by increasing valve PM cycles by 3 times or more
• No chamber pressure change upon pump-off
• Excellent backstream prevention and P/T control

▮ Field Test Data (Polymer Depo.)
Angle Valve for Process Chamber

Customer: DB HiTek
Process: Etch (Metal)
| Company “V” Heating Angle Valve | LAON BPS-CA Heating Angle Valve | |
|---|---|---|
| Comparison Analysis | • Pumping Conductance Decreased ⇒ Reference Pressure: Increased by 150 mTorr (30 mT = 150 mTorr) • PM Cycle: Cleaning once every 2 months | • Improved Pumping Conductance ⇒ Maintain Reference Pressure (30mT⇒30mT) (Reference Pressure: 30mTorr) • PM Cycle: At least three times the cleaning cycle (more than 6 months) |
| Results | • Reduced pumping conductivity due to large polymer deposits • Close O-ring Deposition leak found | • Polymer Deposition insufficient • Maintain Pumping Conductance • Leak Stabilization |
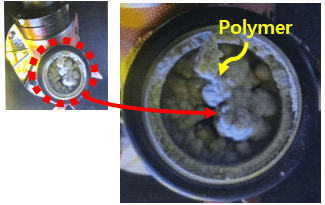
Valve state change after Run Flow for 4 months

Valve state change after Run Flow for 4 months
Angle Valve for Process Chamber

Customer: Gigalane
Process: Etch (Poly)
| Company “V” Heating Angle Valve | LAON BPS-CA Heating Angle Valve | |
|---|---|---|
| Analysis & Results | • PM Cycle: Cleaning once every three months • Particle generation • Reduced Pumping Conductance due to polymer deposition • Leakage due to Close O-ring deposition | • PM Cycle: Cleaning cycle is longer >4 times (~2 years) • Polymer Depo. thickness significantly improved • Pumping Conductance • Leak Stabilization |


Mass production equipment evaluation results
• Reduced maintenance costs by increasing valve PM cycles by 4-8 times or more
• Increased productivity and throughput due to reduced equipment Down Time
• Close Leak stabilized
• Improved pumping conductance
